Так как внешняя поверхность пластины должна быть свободной от посторонних частиц и загрязнений, кремниевые пластины часто подвергают очистке. Для этого применяются:
· Промывка деионизованной водой и моющими средствами;
· Растворители: изопропиловый спирт (IPA), ацетон, этанол, терпены;
· Кислота: плавиковая(HF), серная ![]() , перекись водорода
, перекись водорода ![]() , соляная (HCl), азотная
, соляная (HCl), азотная![]() и их смеси;
и их смеси;
· Каустик: гидроокись аммония ![]() .
.
Нанесение резистов
На поверхность пластины наносят резистивный материал: полимеры на основе растворителей. С помощью центрифуги его распределяют тонким равномерным слоем по поверхности пластины. Затем растворители испаряются, оставляя полимерную пленку. Все резистивные материалы зависят от вызываемых излучением (в основном ультрафиолетовым) изменений в растворимости синтетического органического полимера в специальных веществах-проявителях. Резистивные материалы могут быть негативными и позитивными в зависимости от того, уменьшается их растворимость в проявителе (негативные) или увеличивается (позитивные) под действием излучения. В таблице 83.1 описан состав различных фоторезистивных материалов.
--------------------------------------------------------------------------------
Таблица 83.1 Фоторезисты
|
Ультрафиолетовое излучение | ||||
|
Длина волны (350-450нм) |
негативные |
PB |
Алифатический каучук с азидной основой (изопрен). | |
|
|
позитивные |
PB |
Ортодиазокетон. | |
|
Глубокое |
В основном позитивные резисты |
|
| |
|
Электронно-лучевое (около 100 нм) | ||||
|
|
Негативные |
PB |
Сополимер - этилакрилат и глисидил метакрилат (СОР). | |
|
|
Позитивные |
PB |
Полиметилметакрилат, полифторалкилметакрилат, полиалкилальдегид, полицианоэтилакрилат. | |
|
Рентгеновское (0.5-5 нм) | ||||
|
|
Негативные |
PB |
Сополимер-этилакрилат и глисидилметакрилат (СОР) | |
|
|
Позитивные |
PB |
Полиметилметакрилат, ортодиазокетон, поли (гекса-вторбутилметакрилат). | |
PB=полимерная основа; S=растворитель; D=проявитель.
--------------------------------------------------------------------------------
Так как большинство фоторезистов являются чувствительными к ультрафиолету (UV), производственное помещение освещается специальным желтым светом, в котором недостает ультрафиолета (см. рис. 83.4).
--------------------------------------------------------------------------------
Рис. 83.4 Оборудование фотолитографической "желтой комнаты" в современной чистой комнате
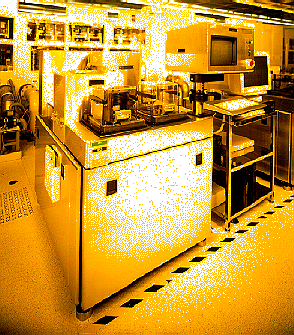
--------------------------------------------------------------------------------
В промышленности применяются главным образом негативные и позитивные резисты, на которые воздействуют ультрафиолетом. Резисты, на которые воздействуют электронные и рентгеновские лучи, также пользуются спросом на рынке благодаря более высокой разрешающей способности. Проблемы охраны здоровья на участках литографии связаны главным образом с позитивными резистами, которые могут оказывать вредное воздействие на репродуктивное здоровье работниц (например, моноэтиловый эфир ацетат этиленгликоля в качестве носителя). Данные материалы постепенно снимаются с производства. Неприятный запах от негативных резистов (например, ксилена) также вызывает неприятные ощущения у работников. Вследствие этого гигиенисты полупроводниковой промышленности часто берут на анализ пробы во время операций с фоторезистами. Обычно воздействие химических веществ во время при обработке в центрифуге и проявлении составляет менее 5% допустимых доз растворителей для атмосферы рабочих помещений (Scarpace et al. 1989).
Во время операции обработки фоторезистов на центрифуге было обнаружено, что воздействие моноэтилового эфира ацетатэтиленгликоля в течение одного часа равно 6.3 ppm [ppm-одна миллионная часть]. Вредное воздействие в основном вызывается плохой организацией работы при техобслуживании (Baldwin, Rubin and Horowitz 1993).
Сушка и предварительный отжиг
После нанесения резиста пластины переносят вручную или по специальной линии из центрифуги в печь с азотной атмосферой и контролируемой температурой. Умеренная температура (от 70 до ![]() ) вызывает затвердение фоторезиста (мягкий отжиг) и испарение остатков растворителей.
) вызывает затвердение фоторезиста (мягкий отжиг) и испарение остатков растворителей.
Для обеспечения адгезии резистивного слоя к пластине на нее наносится вещество для затравки - гексаметилдисилизан (HMDS). Он связывает молекулы воды на поверхности пластины. HMDS наносится либо непосредственно в процессе погружения или обработки на центрифуге, либо посредством испарения, что дает преимущество с точки зрения технологии обработки и стоимости.
Совмещение фотошаблонов и экспонирование
С помощью прецизионной оптико-механической установки фотошаблон и пластина сближаются на очень близкое расстояние, и рисунок фотошаблона совмещается с рисунком, уже существующим на пластине под слоем фоторезиста. Для первого фотошаблона никакого совмещения не требуется. В более старых технологиях совмещение последовательных слоев осуществлялось благодаря использованию бинокулярного микроскопа (с двойными линзами) и методов прецизионного контроля размещения пластины относительно фотошаблона. В новых технологиях такое совмещение выполняется автоматически с помощью реперных точек на пластинах. После совмещения высокоинтенсивный ультрафиолетовый источник с ртутной дуговой лампой или дуговой лампой светит на фотошаблон, экспонируя резист на участках, не защищенных непрозрачными частями маски.
Различные методы совмещения пластин и экспонирования включают: экспонирование в ультрафиолетовом свете (UV) (контактное или близкое), UV экспонирование с помощью проекционных линз для уменьшения (проекция), UV пошаговое экспонирование с повторным уменьшением (проекция), экспонирование в потоке рентгеновских лучей (близкое) и сканирующее экспонирование под действием электронного луча (прямая запись). Основной метод - UV экспонирование с помощью ртутных дуговых ламп и установок проекционного совмещения. UV резисты разрабатываются либо так, чтобы реагировать на широкий спектр UV длин волн, либо так, чтобы реагировать избирательно на одну или несколько из основных спектральных линий, испускаемых лампой (например, g-линия при 435 нм, h-линия при 405 нм и i-линия при 365 нм). Преобладающая длина волны UV света, применяемая в настоящее время в фотолитографии, равна 365 нм и выше, но спектры UV лампы также содержат значительную энергию при длине волны, вредной для здоровья, в фотохимически активной области ниже 315 нм. При нормальных условиях интенсивность UV излучения, исходящего от оборудования, меньше интенсивности солнечного UV излучения в фотохимически активной области и меньше установленных стандартом допустимых доз промышленного UV облучения. Иногда при техобслуживании нужно зарядить UV лампу энергией вне камеры для оборудования или без стандартных защитных фильтров. Уровень облучения во время этой операции может превышать допустимые пределы, но стандартные атрибуты чистого помещения (например, комбинезоны, виниловые перчатки, защитные маски на лицо и защитные очки из поликарбоната с UV фильтром) обычно помогают ослабить отрицательное воздействие UV излучения (Baldwin and Stewart 1989).
![]() Следующая часть документа
Следующая часть документа